- На главную ->
- Приборы ->
- Электронно-лучевая литография ->
- JBX-8100FS
- Описание
- Спецификация
- Применение
Система электронно-лучевой литографии JBX-8100FS
 Рисунок 1. Общий вид электронно-лучевой литографической системы JBX-8100FS
Рисунок 1. Общий вид электронно-лучевой литографической системы JBX-8100FS
Минимальная ширина линии
Для оценки результатов теста производительности и характеристик электронно-лучевого литографа JBX-8100FS, на кремниевую подложку нанесли резист ZEP520A толщиной 50 нм (ZEON Corp.). Экспонирование выполняли при условиях тока пучка 100 пА и минимального диаметра пучка 1,8 нм. При таких параметрах гарантирована минимальная ширина линии 8 нм или меньше. Для получения более ровной структуры резист ZEP520A был проявлен при температуре 2,8 °C, что позволило получить результаты с минимальной шириной линии 4,2 нм (см рис. 2).
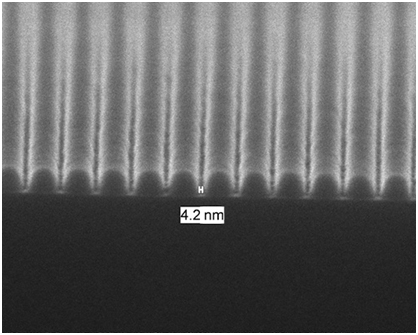
Рисунок 2. Изображение поперечного сечения линии минимальной ширины (× 200k)
Точность сшивки поля
В литографе JBX-8100FS используется система коррекции положения столика, так называемая система управления лазерным лучом Laser Beam Control (далее LBC), обеспечивающая прецизионную коррекцию положения. Кроме того, с добавлением эксклюзивной коррекции искажения материала от JEOL и коррекции искажения отклонения повышается точность сшивки. Для измерения точности сшивания поля использовалась оптическая система измерения координат. Метки «L» были размещены в углах каждого поля обработки, и была обработана схема полей 4 × 4. Были измерены координаты L-образных меток в точках пересечения между полями и оценена точность положения. Результаты для области в 1000 мкм представлены на Рис. 3. Спецификация JBX-8100FS гарантирует точность в пределах ± 20 нм или меньше. Полученные фактические результаты составили +11,5 нм / -9,8 нм (рис. 3 (а)). Даже рисунки Верньера с разрешением 8 нм, размещенные по углам поля, были визуально подтверждены (рис. 3 (б)).
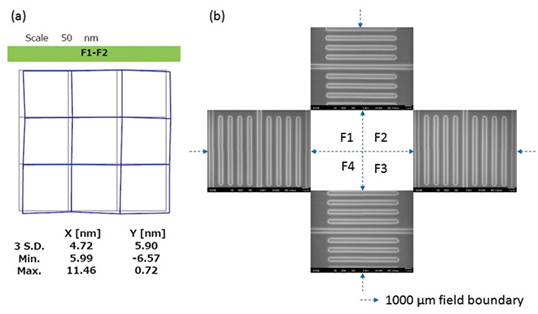
Рисунок 3. Результаты измерения точности сшивания по полю
Точность наложения
Одной из особенностей литографа JBX-8100FS является возможность напрямую экспонировать рисунок на подложку, на которой уже был написан другой узор. Система JBX-8100FS оснащена функцией обнаружения меток, благодаря которой можно обнаружить метки совмещения, созданные на обрабатываемой подложке, и определить советующие координаты. Если позиция нарисованного шаблона записана относительно координат меток выравнивания, отклонение может быть вычислено и исправлено при выполнении экспонирования. Чтобы оценить эту производительность, JBX-8100FS использовался для обработки первого и второго слоя. Площадь экспонирования составляла 30мм×30мм (4×4 точки с интервалами 10 мм). Точность наложения была измерена путем наложения области 3мм×3мм (4×4 точки с интервалами 1 мм) в одном месте в пределах площади 30мм×30мм. Гарантированная производительность составляет ±20 нм или меньше, а фактические полученные результаты составили +4,1 нм / -6,7 нм (рис. 4 (а)). Результаты измерений рисунков Верньера с разрешением 8 нм показали, что наложение было почти идеально центрировано как в направлениях X, так и в направлении Y (рис. 4 (b)).
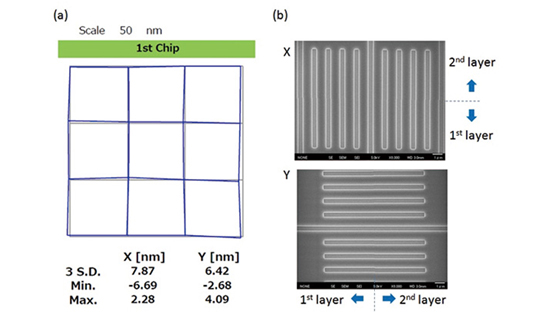
Рисунок 4. Результаты измерения точности наложения
Равномерность критического измерения поля
Для определения равномерности критического измерения поля было выполнено рисование решетки, которая необходима для инжекционного полупроводникового лазера с чирпированным периодом. Линейно-пространственная структура была размещена в центре и в каждом углу поля 1000 мкм. Запись выполнялась с шириной линии 100 нм и шагом 200 нм. В результате точность составила 1,1% р-р с максимумом 100,6 нм и минимумом 99,5 нм (рис. 5).
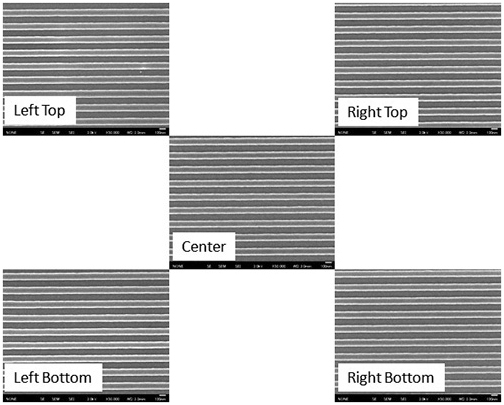
Рисунок 5. Равномерность критического измерения в поле
Стабильность системы
Стабильность параметров системы является важным показателем c точки зрения производительности электронно-лучевого литографа, который работает 24 часа в сутки. Для обеспечения стабильной работы JBX-8100FS компания JEOL предлагает оснащать литограф специальной системой кондиционирования воздуха и компенсатором электромагнитного поля, что позволит добиться еще большей стабильности параметр. Результаты измерений в режиме 100 кВ с высокой производительность и с использованием тока 2 нА показали дрейф тока 0,08% в час, а дрейф положения луча в направлении X: 9,5 нм/ч и в направлении Y: 10,8 нм/ч (рис. 6).

Рисунок 6. Результаты измерения стабильности тока пучка и смещения